

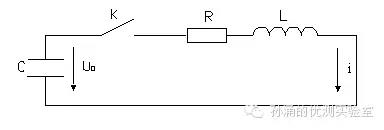
图1 冲击电流装置的主放电回路
Fig. 1 The circuit of impluse current generators
图中,C为电容器;L为回路总电感,包括间隙电感、接线电感、调波电感、负载电感;R是回路总电阻,包括接线电阻、间隙电阻及调波电阻等;K是放电开关。
表1为产生20kA的8/20μs冲击电流的的不同回路参数设计情况。
表1 各种8/20μs冲击电流发生回路参数
Tab1. the parameters of various 8/20μs impulse currentcircuit
|
C/μF |
L/μH |
R/Ω |
U0/kV |
源阻抗RP/Ω |
|
4 8 12 16 20 24 28 32 36 |
18.9 9.45 6.30 4.73 3.78 3.15 2.70 2.36 2.10 |
2.043 1.022 0.681 0.511 0.409 0.341 0.292 0.255 0.227 |
77.640 38.820 25.880 19.410 15.528 12.940 11.091 9.705 8.627 |
3.882 1.941 1.294 0.971 0.777 0.647 0.555 0.485 0.431 |
由表1可知,充电电容C一旦确定,L、R便确定,U0只对放电电流峰值产生影响;电容越大,调波电感、调波电阻越小,输出相同的冲击电流时,所需要的电压就越低。根据以上计算数据拟合出电容C和源阻抗RP的关系曲线如图2所示。
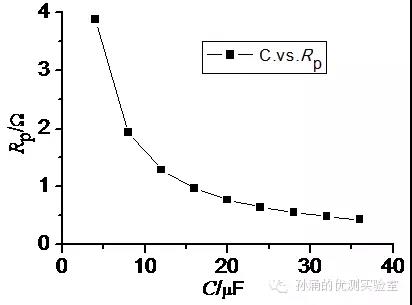
图2 电容和源阻抗的关系曲线
Fig. 2the relationship between capacitors and source impedance
由此得出,电容和源阻抗呈非线性的反比例函数关系,即充电电容减小直接导致源阻抗增大,反之亦然。下面通过建立MOV模型,仿真分析电容(C)、源阻抗(RP)、通流(Itf)和残压(Vres)之间的变化规律。
研究过程中反复强调不同源阻抗的冲击电流回路以及相同预期短路电流,其主要原因在于:
(1)不同回路参数回路的源阻抗不同、试品动态阻抗不同,如果在相同预期短路电流下,通过MOV的电流必然不同,如果对其进行补偿使其满足“流过SPD具有相同8/20μs电流波形峰值”,每次的补偿值也必然不同,不同的试品、不同的回路不能用
同一个补偿系数来补偿。
(2)在相同预期短路电流下,所有试品都拥有相同的测试条件,流过MOV的电流、残压均为研究变量,可以研究相同预期短路电流下不同源阻抗的冲击电流回路对试品的影响。
8/20μs冲击电流发生回路对测试影响(二)
——源阻抗对试品残压的变化规律
以预期短路电流为定量,研究MOV的残压、通流、动态内阻的变化规律,具体方案如下:
(1)源阻抗。0.431Ω~3.882Ω共9种仿真回路;
(2)纵向比较。研究不同源阻抗冲击电流发生回路在不同预期短路电流下,相同试品B32K385的残压、通流变化规律。预期短路电流分别为10kA、20kA和30kA。
(3)横向比较。研究不同源阻抗冲击电流发生回路在相同预期短路电流下,不同试品(B32K385、B40K385、B60K385,其U1mA:620V)的残压、通流变化规律。标称通流能力分别为10kA、20kA、35kA;
1.不同预期短路电流下相同试品残压的变化规律
以B32K385为例,仿真得出的10kA、20kA和30kA冲击电流下残压的变化曲线如图4。
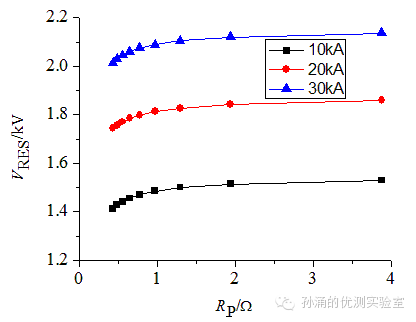
图4 B32K385不同冲击电流下的残压曲线
Fig. 4 the residual voltage of MOV
从上图可以看出:
(1)冲击幅值不同,但三条残压曲线几乎平行,各条残压曲线上对应点的切线斜率几乎处处相等;
(2)冲击电流源阻抗不同,得到的冲击残压也不一样,但在不同幅值的冲击下,各条曲线冲击残压差相差不大。10kA、20kA和30kA冲击电流下,不同源阻抗得到的冲击残压差分别为117.3V、114.7V和120.9V。
(3)以上分析可以引申到计量中,用不同内阻的设备,测试同一个型号的产品时,无论冲击幅值多大,都可以用一个△U来校准测量值。
2.相同预期短路电流下不同试品残压的变化规律
以B32K385、B40K385、B60K385为试品,仿真得到的预期短路电流为30kA时,试品的冲击残压变化曲线如图5。
为比较同一预期短路电流下不同试品冲击残压的差别,将图5(a)中的数据进行处理,具体如下:以B40K385冲击残压线为基准,使其它曲线的第一个残压点与B40K385的重合,得到图5(b)。
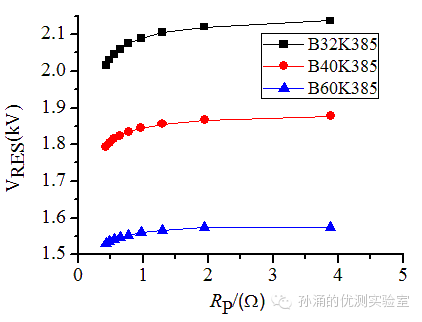
(a)原始残压数据图
(a) the original residual voltage
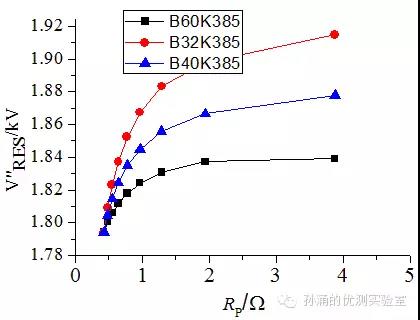
(b)经平移处理后的数据图
(b) the figure after translation handled
图5 30kA下不同试品的残压曲线
Fig. 5 the residual voltage curves of different EUTunder 30kA
从上图得到以下结论:
(1)从图5(b)中的发散趋势可以看出,在同一冲击电流幅值下不同通流能力的试品其冲击残压差异不同。因此计量设备时,不能用不同通流容量的试品来对比两种设备。
(2)对于通流容量小的试品,在同一幅值的冲击下不同源阻抗的冲击电流源,当RP<1Ω时,冲击残压随源阻抗增加呈现急剧增加;当4Ω>RP>1Ω时,冲击残压变化趋于平缓。通流容量大的试品也呈现上述规律,但在整个区间内最大压差相对不大(△U max=45V)。
(3)在计量设备时,小通流的MOV“电压敏感性”较大,适用小通流的试品来反映其最大误差,从上图中可见,B32K385在30kA下B32K385的变化曲线,冲击残压差达到120.9V。
8/20μs冲击电流发生回路对测试影响(三)
——源阻抗对试品动态阻抗和通流的变化规律
1.MOV动态阻抗的变化规律
以B32K385为例,分析在10kA~30kA时其动态阻抗的变化规律。
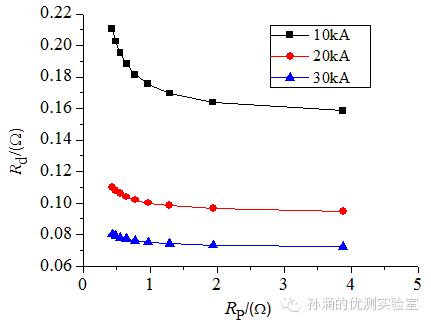
图6 B32K385动态阻抗随冲击电流和源阻抗变化曲线
Fig. 6 the B32K385’s dynamic impedance varies with impluse currentand source impedances
从上图分析可得:
(1)MOV在不同源阻抗的冲击电流回路中所呈现的动态阻抗均随冲击电流增大而减小,这也充分的体现了MOV的非线性特性。
(2)在同一预期短路电流下,Rd随RP增大而减小,在RP<1的区间内,这种变化幅度较明显。
(3)冲击电流越小,试品动态阻抗越大,因此如果在发生器最小的冲击电流下流经非线性试品的冲击电流仍符合IEC 61643-1对冲击电流波的要求,那么此时试品的动态阻抗即可认为是该发生器的最大带负载能力[15,16]。
2.通流变化分析
从大量仿真数据上分析可以看出通流的变化规律和残压的规律相近,但求同存异,仍还有以下几点需要进一步说明。
(1)通流和冲击残压的变化趋势相近,变化率相近,因此以上均只分析残压与源阻抗等之间的关系。
图7为预期短路电流30kA下试品B32K385仿真得到的冲击残压、通流变化规律。
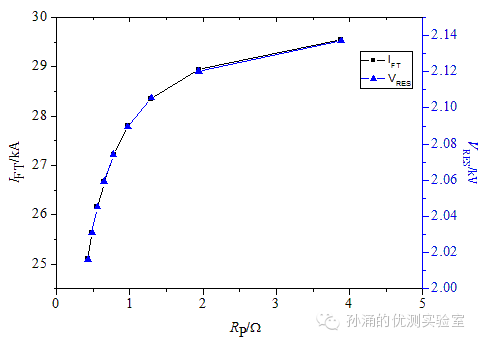
图7 B32K385在30kA下残压、通流变化关系曲线
Fig. 7 the residual and impulse current of MOV under30kA
(2)在相同试品和预期短路电流下,随着源阻抗的变化,通过MOV的电流却发生了变化,因而导致冲击残压的变化,源阻抗对冲击残压有很大影响。因此可以将试品阻抗值预先计算在回路内来调波,这样能有效提高设备的带负载能力。
三期结论:
从分析8/20μs冲击发生回路入手,分析其参数间的关系,利用大规模的仿真计算,分析冲击电流源阻抗、MOV残压之间的关系,再结合实际测试,验证仿真结论。由此得到些结论如下:
(1)脉冲电容和源阻抗呈现非线性的反比例关系,电容越大源阻抗越小,反之亦然。
(2)同一预期短路电流下,冲击电流回路的源阻抗越低,所需充电电压越小,测试同一的试品时,冲击残压随源阻抗增大而增大。
(3)不同预期短路电流下,不同源阻抗冲击电流回路测试同一试品时,冲击残压差基本保持一致,因此在计量中,用不同源阻抗的冲击电流回路测试同一个试品时,无论冲击电流幅值多大,都可以用一个△U来校准测量值。
(4)不同预期短路电流下,不同源阻抗冲击电流回路测试不同试品时,通流容量越小的试品其表现出来的电压敏感性越大,大通流的试品在大电流冲击下受源阻抗的影响较小,因此在设备计量时宜选用小通流容量的MOV来测试对比不同发生系统的性能。冲击电流越小,试品动态阻抗越大,在工程计算设备带负载能力时,适用其最小冲击电流来测试试品。
8/20μs冲击电流发生回路对测试影响(四)
——MOV老化特性的实验研究
利用三台经过计量的具有不同源阻抗的8/20μs脉冲发生器对同一厂家、同一批次、同一型号的MOV型浪涌保护器进行大规模测试,分析发生器设备对MOV的劣化程度的影响。试验方案确定如下。
(1)合理抽取测试样本。从同一厂家、同一批次、同一型号的100只产品中随机抽取三只用来测试。
(2)使用Haefelypsurge 30.2,源阻抗0.432Ω;ICGS测试系统,源阻抗0.799Ω;利用XJTU 8/20兼容10/350测试系统源阻抗0.52Ω作为验证。
(3)试品参数:U1mA: 680V,In: 20kA,Imax: 40kA,UC: 420V,Size: 34*34。
(4)测试方法:三台设备分别对三个样品进行90次冲击;调整充电电压使得流过浪涌保护器的电流峰值为20kA±0.5kA;每冲击一次冷却至室温后记录U1mA;测试前、测试50次时和最后一次冲击后测量MOV的相对介电常数、介质损耗角正切值tanδ;两次冲击时间间隔大于90s(需要拆下测量各种静态参数)。
1.U1mA变化规律
将测试得到的数据得到的变化趋势如下图所示:
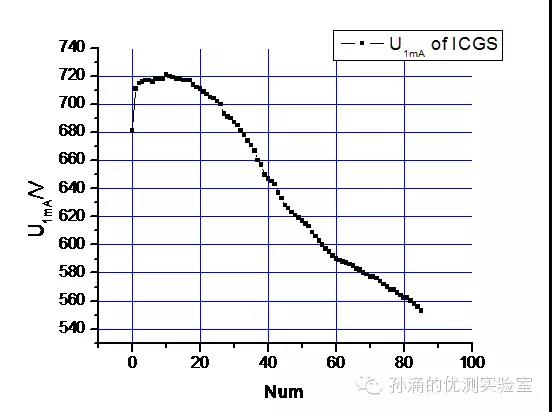
(a) ICGS系统下U1mA变化规律
(a) the regular of U1mA under ICGS testing system

(b) Haefely系统下U1mA变化规律
(b) the regular of U1mA under Haefely testingsystem
图1 两种源阻抗设备下U1mA变化趋势
Fig.1 the U1mA trandlines ofthe two generators
分析U1mA可以得到如下结论:
(1)由于MOV的电容效应,试验结果U1mA随着测试次数的增加,均呈现在前几次内快速上升,并保持稳定变化,当测试达到一定次数后快速下降的趋势。冲击电流经过时,高频有一部分是经过电容的,形成电容电流,并且通过电容的电流的速度比晶界击穿的速度快。晶界之间的距离是固定的,晶粒的损坏方式不同,决定了压敏电压变化趋势不同。
晶粒的损坏形式主要有两种:粉碎性损坏和熔穿性损坏。粉碎性损坏使晶粒之间距离变大,压敏电压向高变化;熔穿性损坏使晶粒之间距离变小,压敏电压向低变化;在初始冲击阶段,晶粒以粉碎性损坏为主,压敏电压向高变化;随着损坏数量的增多积累,局部阻性增大,损坏的形式开始转向熔穿,压敏电压转向低变化[9-10]。
(2)当冲击超过一定次数后,U1mA稳步下降,如表1所示。
表1 U1mA劣化程度与测试次数关系
Tab.1 the relationship between degradation degree of U1mA and testing numbers
|
设备 |
源阻抗 /Ω |
初始U1mA /V |
下降至5%的次数 |
下降至10%的次数 |
|
Haef XJTU ICGS |
0.43 0.52 0.79 |
677 697 681 |
79 68 40 |
90 83 52 |
在一定次数的冲击中,压敏电压保持稳定,这是由MOV的耐冲击能力决定的,当冲击超过一定次数后,晶粒出现粉碎性破坏,单位厚度内有效晶粒数减少,使得U1mA降低。ICGS冲击到22次左右,Haefely冲击到56次左右U1mA出现“拐点”,即不能保持稳定而开始稳步下降,这说明MOV已经老化到劣化的边缘了。ICGS冲击到40次左右,Haefely冲击到70次左右U1mA的下降速度加快,此时根据U1mA即可判定MOV完全失效。
(3)设备源阻抗越大对MOV的老化考验越严酷。从图中可以清楚的看出,源阻抗为0.799Ω的ICGS测试系统相对0.432Ωhaefelypsurge30.2对MOV的老化考验更严酷,前者U1mA在第22次就开始下降,后者U1mA保持到56次才开始缓慢下降;从表中可以看出,随着源阻抗的增加U1mA下降的速度明显变快,直至超出10%。阻抗0.432Ω设备下,90次冲击后U1mA下降18.94%;阻抗0.799Ω设备下,U1mA下降9.3%,源阻抗越大,使通过MOV具有相同峰值的电流时,MOV老化速度越快。
2.冲击前后介电特性的变化
以其中ICGS测试的试品冲击前后,MOV老化过程中,其介电特性的变化规律,图2和图3为冲击电流幅值为20kA,冲击次数分别为50次和90次的相对介电常数εr和介质损耗tanδ变化的对比。
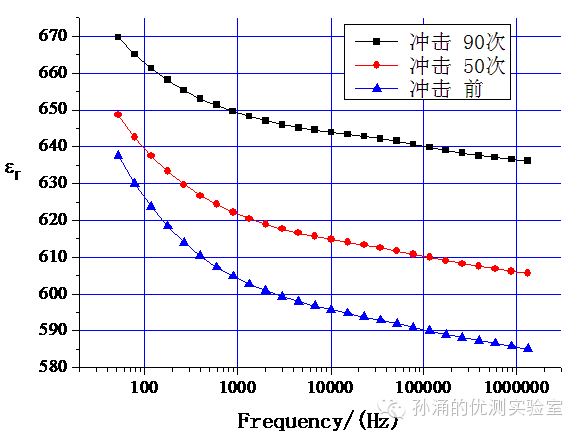
图2 冲击电流幅值为20kAεr值变化
Fig. 2 theεr varies under 20kA implusecurrent
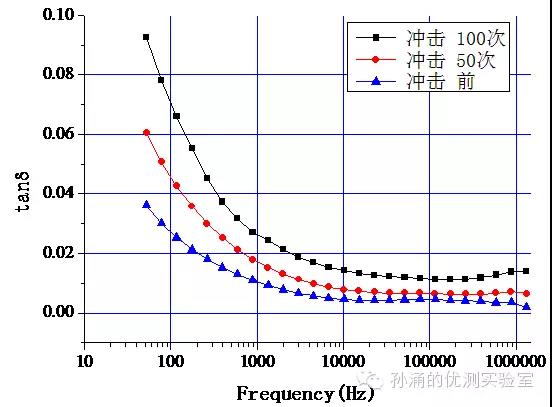
图3 冲击电流幅值为20kAtanδ值变化
Fig. 3 the tanδ variesunder 20kA impluse current
图2、3的对比中可以看出
(1)冲击作用前,非线性电阻片的相对介电常数εr与介质损耗tanδ随频率变化的曲线出现:εr随着频率的升高而减小,tanδ在105Hz附近出现了“弥散区”;在同一频率处,冲击后介质损耗tanδ值要大于受冲击前的值,随着冲击次数的增加,tanδ的曲线中“弥散区”有逐渐消失的趋势。
(2)冲击后,相对介电常数εr随频率变化的曲线发生了漂移,并且在同一频率处,对应的相对介电常数εr值要大于冲击前的值;随着冲击次数的增加,ZnO非线性电阻片介电特性表现为介电常数和介质损耗角正切值增加的幅度加大。
对介电参数的变化可以这样解释为:
(1)冲击作用后,电阻片发生老化,部分晶界遭到破坏,使得不同的晶粒界面结合在一起,从而使得晶粒界面面积增大,进而使得晶粒的体电阻减小,因此在施加相同电压的情况下,漏电流增大,电导损耗增大。由于非线性电阻片内部存在多个不同松弛时间的松弛机构,这些松弛时间相差不很大的多个松弛运动产生的松弛极化构成了非线性电阻片松弛极化损耗。随着冲击次数增加,电阻片的电导损耗增大,其程度远超过了极化损耗,而电导损耗随频率的变化,是不存在“弥散区”的,因此,随着冲击次数增加,tanδ曲线中的“弥散区”逐渐消失,且随着冲击次数增加损耗值越大。
(2)冲击作用后,部分晶界遭到破坏,等效串并联网络中的电容数量减小;而破坏后的晶粒间的界面面积增大,使得晶粒界面间电容的增大,这两种结果都将导致电容的增大,因此相对介电常数的增大,且冲击次数和冲击电流幅值的增加,晶界破坏程度越大,老化程度越严重,相对介电常数的增大也就越明显。
本文转载自: 孙涌的优测实验室
安迅防雷www.ansunspd.com